1.Wire bond原理: 对金属丝和压焊点同时加热和超声波,接触面便产生塑性变形,并破坏了界面的氧化膜,使其活性化,通过接触面两金属之间的相互扩散,形成金属化合物而完成连接。
2.常用线材: 金线,Ag合金线,钯铜线,纯铜线。 基于0.8mil,20um各种线材特性比较如下: 金线的主要优点: 硬度低,应力小,不容易产生弹坑。 抗氧化性好,在高温高湿下环境下的长期可靠性好。 缺点:成本较高,金属迁移率高,相比其他线材易产生Kirkendall Void。
银合金线的主要优点: 硬度低,应力小,不容易产生弹坑,成本低。 缺点:相比其他线材断裂载荷偏小。
铜线的主要优点: 成本低,电阻率小,金属迁移速率低,高温不易产生Kirkendall Void。 缺点:硬度大,容易产生弹坑,高温高湿下易腐蚀。
铜线和钯铜线优缺点比较: 1)钯铜线具有更好的耐腐蚀性 2)钯铜线开封后可以存储7天,纯铜线只能存储3天。 3)钯铜焊接时在纯氮气环境下,纯铜线需要在氮氢混合气体中。
3.Wire Capillary (劈刀):
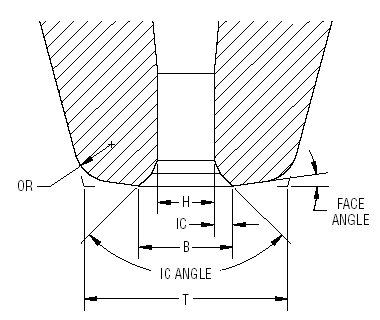
Capillary主要的尺寸
- H:Hole Diameter
- T:Tip Diameter
- B:Chamfer Diameter (orCD)
- IC:Inside Chamfer
- IC ANGLE:Inside Chamfer Angle
- FA:Face Angle (Face角)
- OR:Outside Radiu
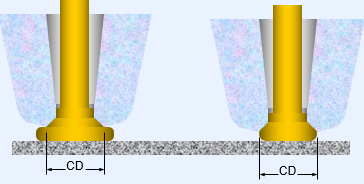
CD径过大,Bonding強度越弱,易造成虛焊。
Chamfer角:小→Ball Size:小 Chamfer角:大→Ball Size:大 OR(Outer Radius)及FA(Face Angle):对Hill Crack、Capillary的OROuter Radius)及FA(Face Angle)的数值是重要影响因素
4.Wire Bonding的过程:
1) 焊头在打火高度 2) 焊头由打火高度下降到第一焊点搜索高度 3)第一焊点接触阶段 4)第一焊点焊接阶段 5)完成第一点压焊后, 焊头上升到反向高度 6)焊头上升到线弧高度位置 7)XYZ 移向第二压点搜索高度 8)第二压点焊接階段 9)焊头在尾丝高度,拉断尾丝。

First bond:
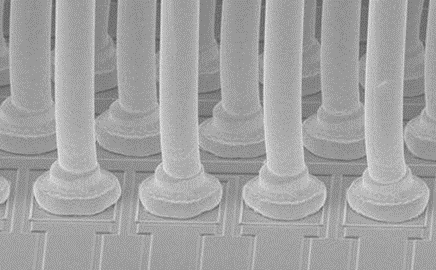
2nd Bond:
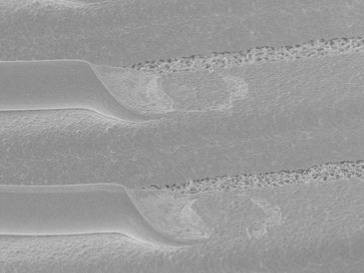
线弧:

5.Wire Bonding的主要参数:Time(时间) 、Power(功率)、Force(压力) 、Temperature(温度)
6.Wire bonding 的弧形:
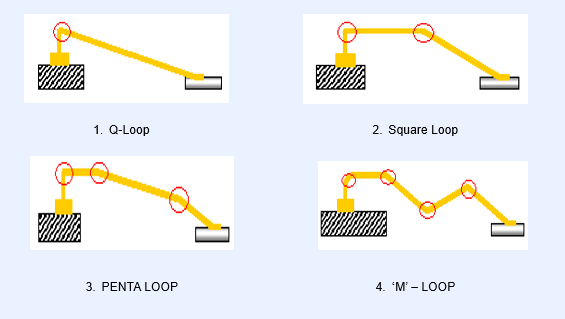
BPO: Ball Pad opening BPP: Ball pad Pitch 下表为不同直径金线的直径对应的最小BPO/BPP 和最大线长。
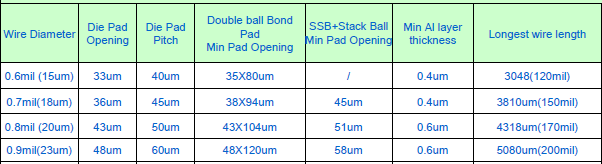
BPO至少5um。 最大弧长是根据芯片高度,焊针尺寸,弧高要求,芯片偏移量,线径通过实验得到的安全长度。 6.Wire bond 测试: 主要项目Wire pull test (拉力测试), ball shear test(第一点推力测试) , stich pull test (第2点拉力测试), IMC coverage(金属化合物覆盖率),Crater test (弹坑实验), remain Al thickness(铝垫残留厚度)及可靠性试验后的Cross section。
本文作者:闫妍
点击查看原文